چهارشنبه 24 دی 1399 کد خبر: 78
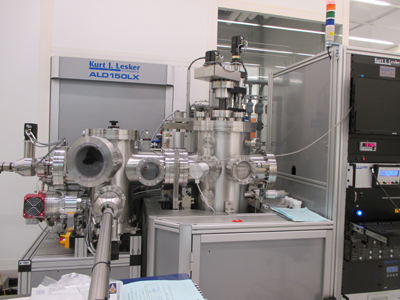
۱- مقدمه
رسوبدهی لایه اتمی ()[۱] یک روش منحصر به فرد برای رشد لایههای نازک به شمار میرود که با سایر روشهای رایج تشکیل فیلمهای نازک، تفاوت قابل توجهی دارد. روش رسوبدهی لایه اتمی ذاتا ماهیت رشد محدود کنندهای دارد و هر بار تنها یک لایه اتمی یا مولکولی میتواند روی سطح رشد یابد. بنابراین، به کمک این روش بهترین کنترل را بر ضخامت فیلم و صافی سطح در ابعاد نانومتری و یا کمتر، خواهیم داشت. در مقایسه با سایر روشهای تشکیل فیلم، رسوب لایه اتمی روشی نسبتا جدید است که اولین بار برای رشد فیلم ZnS استفاده شد. ALD را میتوان به عنوان اصلاح کننده روشهای رسوبدهی شیمیایی فاز بخار (CVD)، یا ترکیبی از خودآرایی فاز گازی و واکنشهای سطحی در نظر گرفت.
۲- شرح فرآیند رسوب دهی لایه اتمی
در فرآیند معمول رسوبدهی لایه اتمی (ALD) ابتدا سطح توسط واکنش شیمیایی فعال میشود. هنگامی که مولکولهای پیشماده به محفظه رسوبدهی وارد میشوند با گونههای سطح فعال واکنش میدهند و پیوند شیمیایی ایجاد میکنند. از آنجایی که مولکولهای پیشماده با یکدیگر واکنش نمیدهند، بیش از یک لایه مولکولی نمیتواند در این مرحله رسوبگذاری شود. در مرحله بعد، تکلایه رسوب داده شده دوباره از طریق واکنش شیمیایی سطح فعال شده و مولکولهای پیشماده وارد محفظه میشوند. در این مرحله با توجه به نوع لایه میتوان از پیشماده متفاوتی هم استفاده کرد. با تکرار این مراحل، لایههای اتمی و یا مولکولی را در هر مرحله میتوان رسوب داد. شماتیک روش رسوبدهی لایه اتمی در شکل زیر نشان داده شده است[۲و۱].

شکل۱- نمای کلی فرآیند رسوبدهی لایه اتمی. آ) سطح زیرلایه اصلاح شده. ب) واکنش پیشماده A با سطح. پ) خروج پیشماده اضافه و محصولات جانبی تولید شده. ت) واکنش پیشماده B با سطح. ث) خروج پیشماده اضافه و محصولات جانبی تولید شده. ج) تکرار مراحل ۲ الی ۵ تا هنگامی که به ضخامت دلخواه برسد [۲]
۱-۲-رشد لایه دیاکسید تیتانیوم
شکل۲ شماتیک فرآیند رشد لایه دیاکسید تیتانیوم را به روش ALD نمایش میدهد.
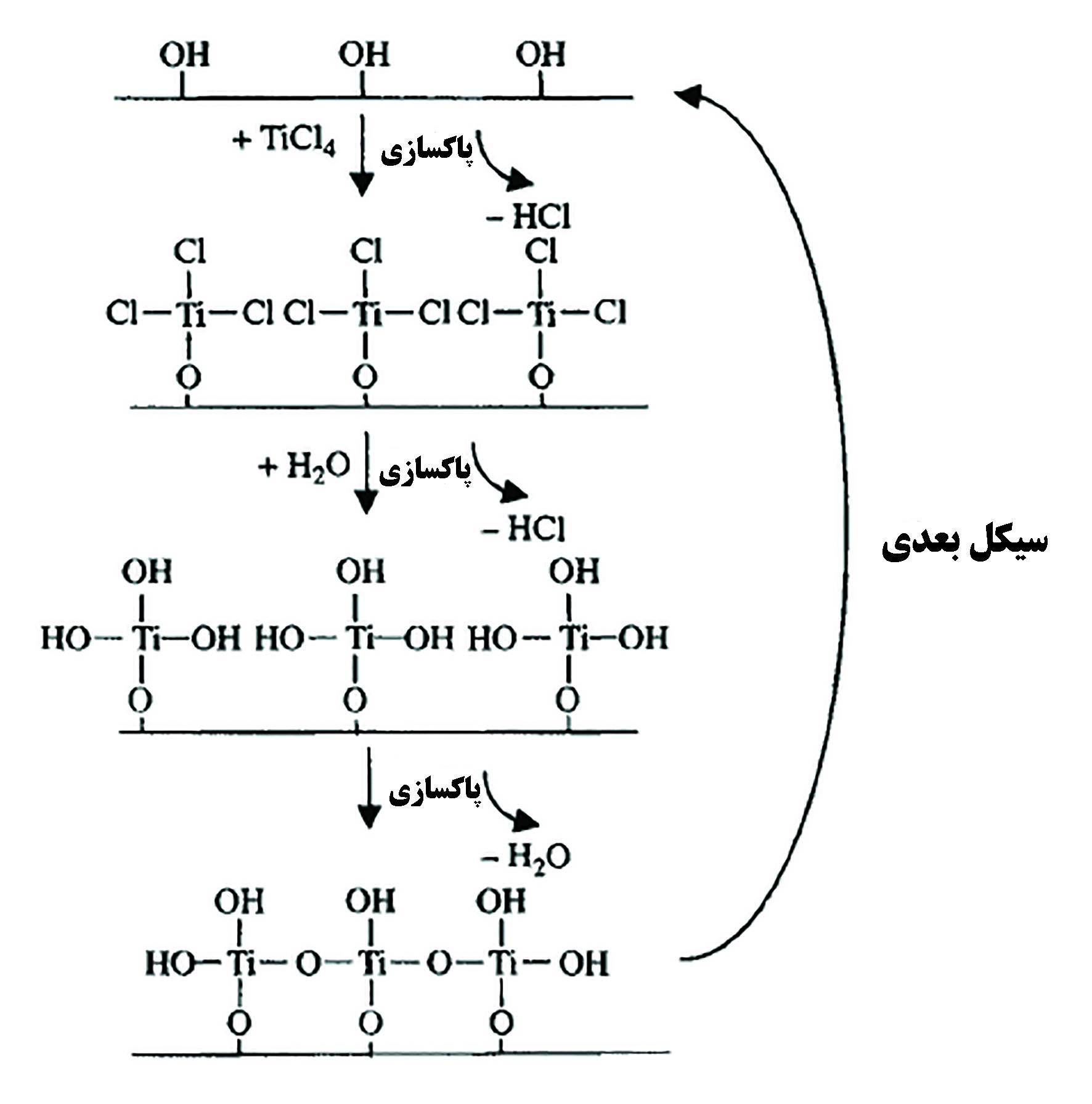
شکل۲- شماتیک فرآیند ALD برای تشکیل فیلم دیاکسید تیتانیوم [۱]
ابتدا سطح بستر هیدروکسیله میشود، سپس قبل از ورود پیشمادهها، تیتانیوم تتراکلراید با گروههای هیدروکسیل سطح واکنش میدهند که نوعی واکنش تراکمی روی سطح است:
Me بیانگر بستر فلزی و یا اکسید فلزی است. واکنش بالا تا زمانی که تمامی گروههای هیدروکسیل سطح با تتراکلرید تیتانیوم واکنش دهند، ادامه مییابد. محصولات جانبی تولید شده مانند هیدروکلریک اسید از سیستم خارج شده و آب وارد میشود. تریکلرید تیتانیوم به صورت شیمیایی با سطح پیوند داده و در حضور آب هیدرولیز میشود.
های مجاور یکدیگر آماده واکنش تراکم هستند تا پیوند Ti-O-Ti را ایجاد کنند:
هیدروکلریکاسید تولید شده و آب اضافی از محفظه خارج شده و یکلایه دیاکسید، طی یک سیکل کامل روی زیرلایه تشکیل میشود. گروههای هیدروکسیل موجود روی سطح آماده هستند تا با مولکولهای پیشماده تیتانیوم در چرخه بعدی واکنش دهند. با تکرار مراحل بالا، لایههای بعدی دیاکسیدتیتانیوم و یا بسیاری از مواد دیگر را میتوان به صورت کاملا کنترل شده روی سطح لایهنشانی کرد [۲و۱].
رشد لایههای ZnS مثال کاربردی دیگری از فرآیند ALD است. در این فرآیند ZnCl2 و H2S به عنوان پیشمادههای واکنش استفاده میشوند. ابتدا ZnCl2 روی زیرلایه جذب شیمیایی شده و سپس H2S وارد شده تا با ZnCl2 واکنش دهد. تکلایه ZnS روی زیرلایه تشکیل شده و همواره محصولات جانبی دیگری نیز خواهیم داشت که در نهایت از سیستم حذف میشوند. طیف گستردهای از مواد به عنوان پیشمادههای واکنشهای شیمیایی برای تهیه لایه نازک به روش ALD مورد مطالعه قرار گرفتهاند. انتخاب پیشمادههای مناسب، مسئله اساسی در طراحی موفق یک فرآیند ALD است. به طور مثال در اولین آزمایشات تولید ZnS از روی و سولفور عنصری استفاده شد. کلریدهای فلزی اندکی بعد مورد استفاده قرار گرفتند. همچنین ترکیبات آلی-فلزی نیز کاربرد دارند. ویژگیهایی که برای انتخاب پیشماده در روش ALD باید مد نظر داشت را میتوان به طور خلاصه به صورت زیر بیان کرد:
در مقایسه با سایر روشهای رسوبدهی فاز بخار، روش ALD مزایای خاصی همچون کنترل دقیق ضخامت و ایجاد پوششی یکنواخت و همدیس[۲] را به همراه دارد. کنترل دقیق ضخامت فیلم به دلیل ماهیت محدودکننده واکنش است که میتوان با شمارش تعداد چرخههای واکنش، ضخامت لایه را کنترل کرد. این روش در برابر تغییرات درجه حرارت و توزیع غیر یکنواخت بخار در ناحیه واکنش بیاثر باقی میماند. با این حال باید توجه داشت که ایجاد چنین لایهای در صورتی که پیشماده به میزان لازم وجود داشته و زمان لازم برای رسیدن به حالت اشباع در هر مرحله داده شود، میتواند ایجاد شود. با این حال بسیاری از کاربردهای این روش به دلیل زمانبر بودن رسوب لایه اتمی که معمولا کمتر از ۰/۲ نانومتر در هر چرخه است، با محدودیت مواجه میشوند [۲و۱].
۳- جمعبندی و نتیجهگیری
تهیه لایهنازک به روش رسوبدهی لایه اتمی یک روش خاص و کاربردی است که با سایر روشهای موجود بسیار متفاوت است. در این روش در هر مرحله با توجه به واکنشهای امکانپذیر در سطح که خود محدودکننده نیز به شمار میروند، تنها یکلایه اتمی یا مولکولی میتواند روی سطح رشد یابد و بهترین کنترل ضخامت و صافی سطح را ایجاد میکند. نکته حائز اهمیت در این روش انتخاب درست پیش مادهها و کنترل شرایط واکنش است تا رسوبدهی به طور کامل و صحیح صورت گیرد.
۴- مراجع
[1]. Guozhong, Cao. Nanostructures and nanomaterials: synthesis, properties and applications. World scientific, 2004.
[2]. Johnson, Richard W., Adam Hultqvist, and Stacey F. Bent. "A brief review of atomic layer deposition: from fundamentals to applications." Materials today 17.5 (2014): 236-246.
۵- پاورقی
[1]Atomic Layer Deposition (ALD)
[2]Conformal